薄膜铌酸锂(一):LNOI晶圆制备技术
薄膜铌酸锂晶圆(LNOI)的生产制造技术与传统SOI晶圆制造方法相同,大多基于"Smart-cut"技术实现,该项技术专利于1998年申请【1】,到2018年截止,目前该项专利技术已经不受专利保护,可无偿使用。
LNOI晶圆制备过程如下下图所示,包括以下五个步骤:(1)离子注入;(2)衬底准备;(3)薄膜键合;(4)退火及剥离;(5)CMP平坦化。
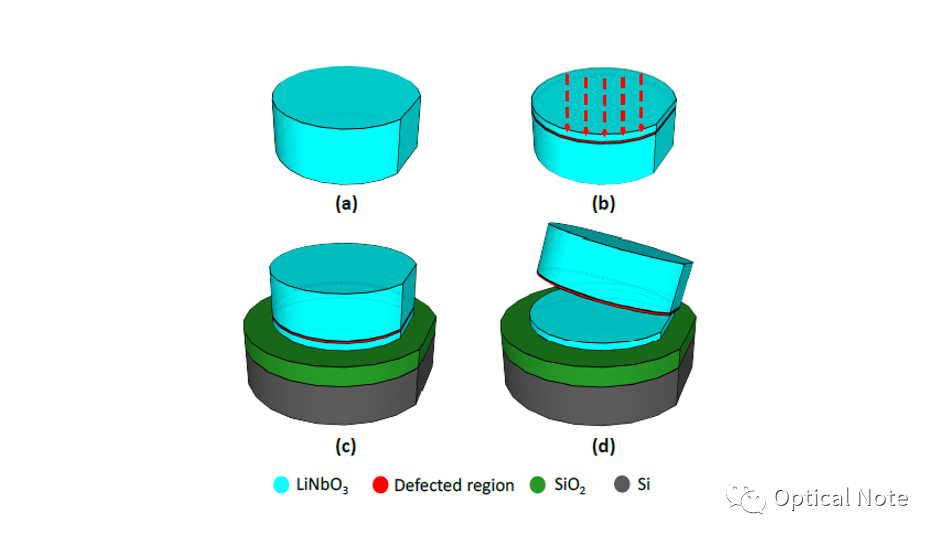
LNOI晶圆制备工艺流程图
(a)单晶铌酸锂晶体准备;(b)He离子注入;(c)薄膜键合;(d)退火、剥离并做CMP平坦化处理。
第一步:离子注入
如下图b所示,利用离子注入机,从铌酸锂晶体上表面打入高能的He离子,特定能量的He离子进入晶体后,受到LN晶体中原子和电子的阻挠,会逐渐减速并停留在特定深度位置,破坏该位置附近处的晶体结构,将LN晶体分成上下A/B两层,而A区将会是我们需要制备LNOI所需要的薄膜。

离子注入工艺图:
(a)单晶体材料铌酸锂;(b)He离子注入到LN晶体中,注入深度0.6um,将LN分成A/B层;(c)带有切边的单晶铌酸锂晶体实物;(d)He离子在晶体中的浓度随深度的变化情况(该分布曲线只是定性示意曲线,不具备实际意义)
说明:
(1)原始基材:加工LN的基材是体材料铌酸锂(单晶铌酸锂晶棒),如上图c所示,经过处理后的单晶铌酸锂晶体成圆柱形状,其直径决定了生产的LNOI晶圆尺寸(3寸 75mm,4寸 100mm)。
(2)晶圆切边:从上图c中,可以看到圆柱晶体有个平面切面,这个切面也对应成品晶圆的切边,切边的作用是方便辨别晶体的晶向,切边的方向通常与晶体的某一晶向保持平行。
(3)He离子分布与薄膜厚度:He离子能量的高低,将决定离子进入晶体的深度,也决定了A层LN薄膜的厚度。在特定加速电场下,所有He离子进入晶体特定深度位置,形成一个分界面。由于He离子的能量几乎相同,在分界面附近离子呈现高斯分布状态(如上图d)。
(4)注入损伤:He离子在实际注入过程中,需要从晶体上表面逐渐向下渗透,并达到特定深度位置。在这个过程中A层的薄膜晶体也是会受到He离子的撞击而产生一些损耗,破坏晶体原有的性能。如上图b所示,为了表述这一情形,我在图中A层区域绘制了一条黑色折线段,用于表征A层薄膜属于部分破坏状态。关于A层薄膜注入损伤修复,会在后面的工艺中讲到。
第二步:衬底制备
要做薄膜铌酸锂晶圆,肯定不能让几百nm的LN薄膜处于悬空状态,必须有底层支撑材料。常用的SOI晶圆,衬底都是一层厚度大于500um的硅晶圆,然后在其表面制备SiO2介质层,最后将单晶硅薄膜键合在上表面,形成SOI晶圆。
对于LNOI晶圆一样,常用的衬底有Si和LN这两种材料,然后通过热氧或PECVD沉积工艺制备SiO2介质层,如果介质层表面不平整,还需要化学机械研磨CMP工艺,使其上表面光滑平整,便于后续的键合工艺。
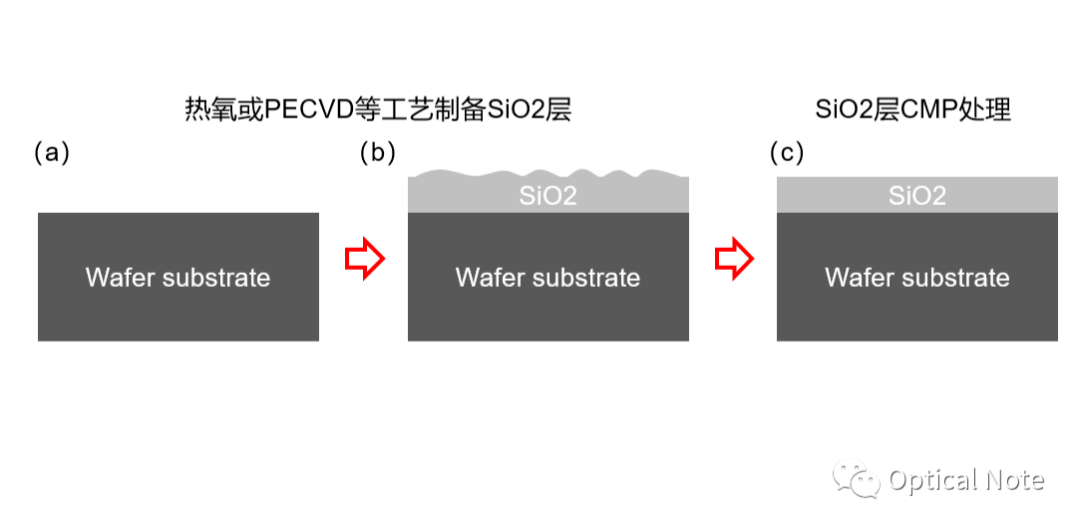
衬底制备流程图:(a)商业化晶圆衬底Si或LN等;(b)SiO2介质层制备;(c)介质层表面CMP处理
第三步:薄膜键合
利用晶圆键合设备,将注入离子后的LN晶体反转180度,键合到衬底上。对于晶圆级生产而言,衬底与LN两者的键合表面都做了平整化处理,通常采用直接键合方式键合,中间不需要粘结剂材料。
而对于科学研究而言,还可以采用BCB(benzocyclobutene)作为中间层粘结剂材料,实现Die to Die的键合,采用BCB键合方式,对键合表面平整度要求较低,非常适合于科研实验中。但是BCB不具有长期稳定性,所以在晶圆生产中,通常不会采用BCB键合。
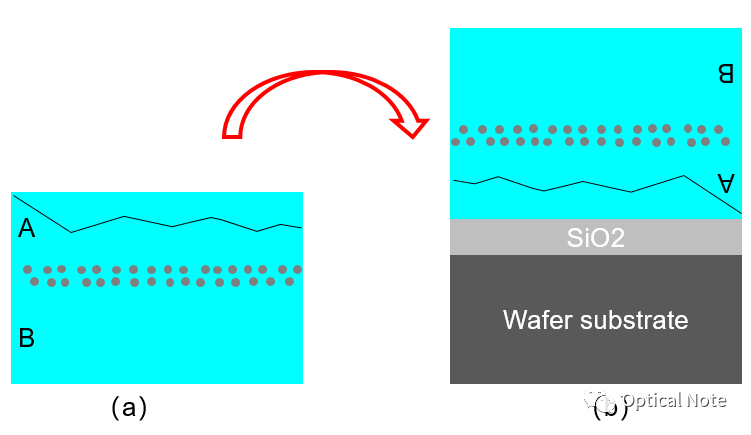
LN与衬底键合工艺
第四步:退火及剥离
将两种晶体表面贴合挤压后,还需高温退火及剥离工艺。两种晶体表面贴合后,首先在特定温度下维持一定时间,加强界面键合力,同时使得注入离子层气泡化,使得A,B两层薄膜逐渐分离开,最后用机械设备将两者剥离开,然后再逐渐降低温度至室温,完成整个退火及剥离工艺。退火工艺作用:
(1)较高的温度能够使得键合界面的键合力增加,使得键合的薄膜更牢固。
(2)较高的温度能偶使得注入离子层气泡化,使得A,B两层薄膜逐渐分离开。
(3)高温退火也会修复A层薄膜内受离子注入损伤的晶体,使其恢复单晶材料特性。
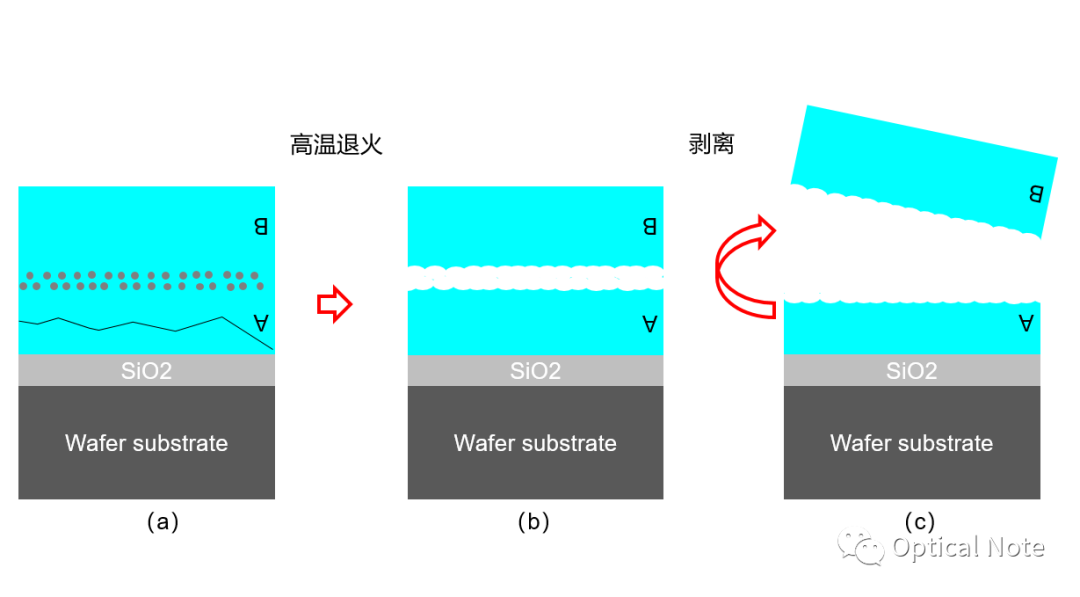
退火及剥离工艺:(a)两种材料界面贴合;(b)高温退火,界面键合力增加,A/B层气泡化分离;(c)完全剥离
第五步:CMP平坦化
经过退火剥离后的LNOI晶圆,其表面是粗糙的,不平整的,需要进一步做CMP平坦化处理,使得晶圆表面薄膜平整,降低表面粗糙度。
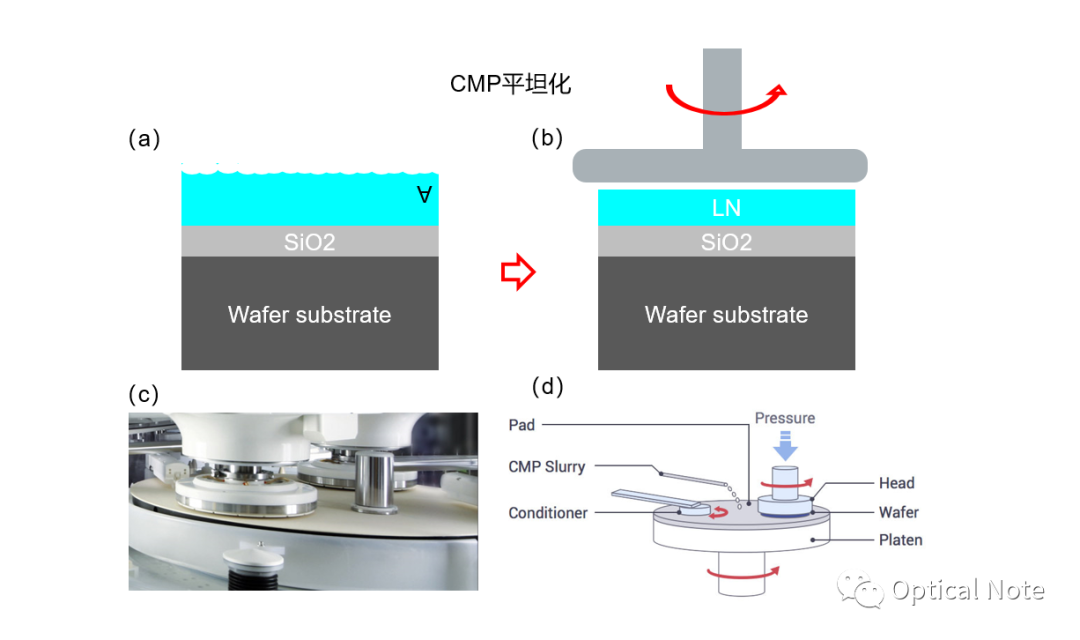
薄膜表面CMP平坦化处理:(a)剥离后的LNOI晶圆;(b)LNOI表面CMP处理示意图;(c)CMP设备实物图;(d)CMP工作示意图。
参考文献
【1】Crystal ion-slicing of single-crystal films (USPTO patent 6120597 September 19, 2000)
【2】Thin-fIlm Lithium Niobate Integrated Photonics on Silicon for Electro- and Nonlinear-optic Applications

