激光器芯片及TO、C-mount、多晶粒封装
以下文章来源于芯片工艺技术 ,作者丁不四
一、Laser Die 及其制备
激光器芯片根据材料体系有GaN基蓝光系列、砷化镓、磷化铟等组合起来的三元或者四元体系。每一种体系由于其最优的外延基板不同,P、N面打金线方向不同,有正负极同向、有反向。
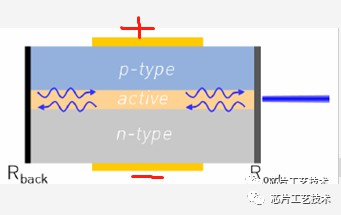
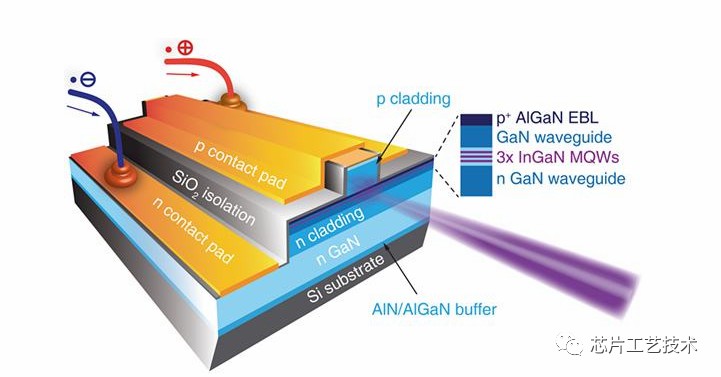
激光芯片根据使用范围主要有大功率应用的可见光、通讯用的红外光,还有医疗美容用的800~980nm的红外光,根据功率值要求,芯片设计的大小也是区别很大。
比如芯片的长度,宽度,发光带的宽度。
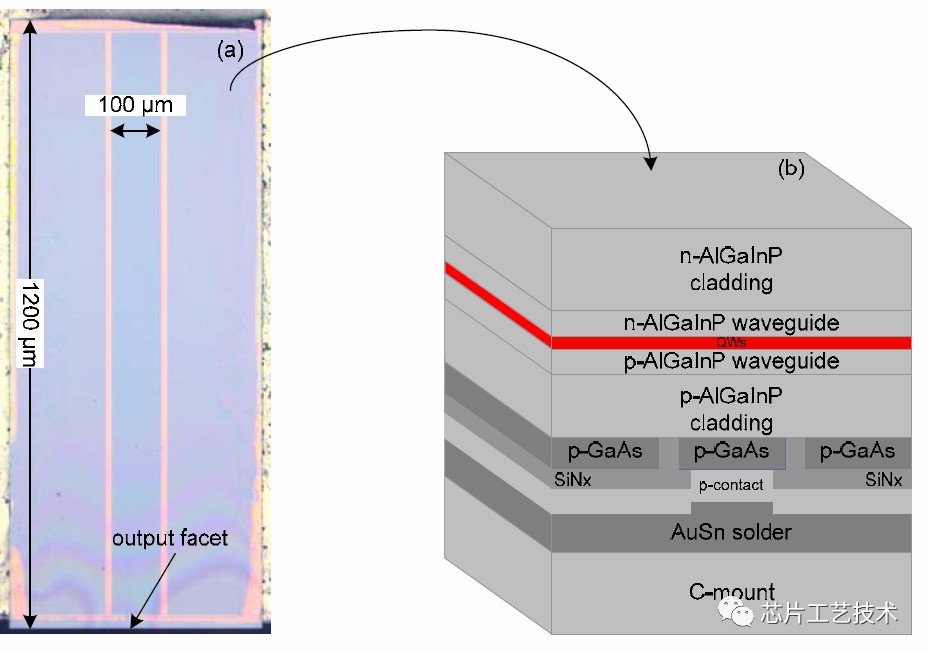

对于大功率的激光器,需要更长的谐振腔长,1000um以上是经常的。对于小功率的通讯用激光器一般100um左右即可,如下图。

金线的焊盘直径一般在80um左右,因此对于小芯片需要特别设计打线位置。

同时根据需要可以在一个芯片上设计多个发光带,根据需要可以有很多,也叫芯片级集成,优点是同样大小的芯片光功率大很多。缺点是散热要求高。
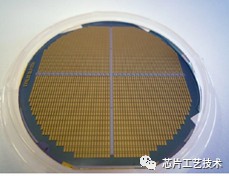


芯片制备过程
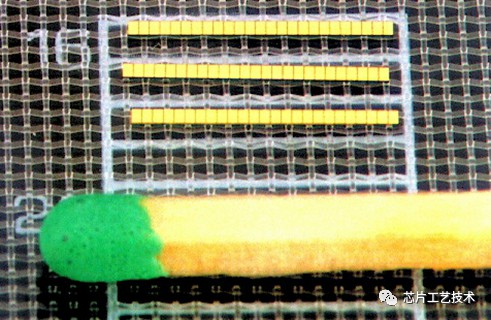
做成wafer的激光器需要先解离成Bar条,然后进行堆bar镀膜。如上图。
二、激光芯片的封装
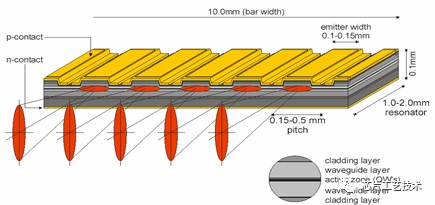
为了得到更大功率、散热效果还可以的激光器,人们常用一整条Bar条封装成激光器。
以每个发光单元2W,有源区尺寸1um×100um计算,体发热密度2×1010W/m3。以50%电光转换效率计算,一个典型的中等功率50W/bar,腔长为1mm,热流密度为500W/cm2,电流密度1000A/cm2
因此为了散热效果,需要把P面朝下,和热沉直接接触。因为有源区更靠近P面,有源区距离P面的距离一般在200nm以内,到N面大概有90um。因此为了让热更短距离的传到到热沉上,把热沉做正极,上表面做负电极。
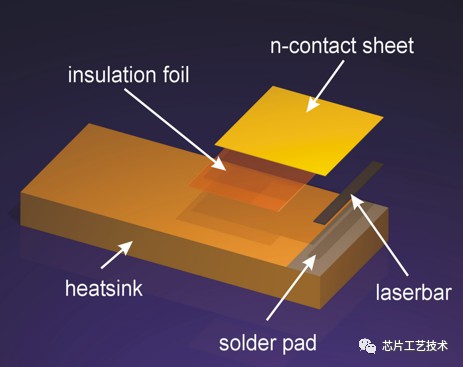
单管激光芯片的封装主要有TO-can和C-mount, Q-mount等封装方式。
2.1 C-mount
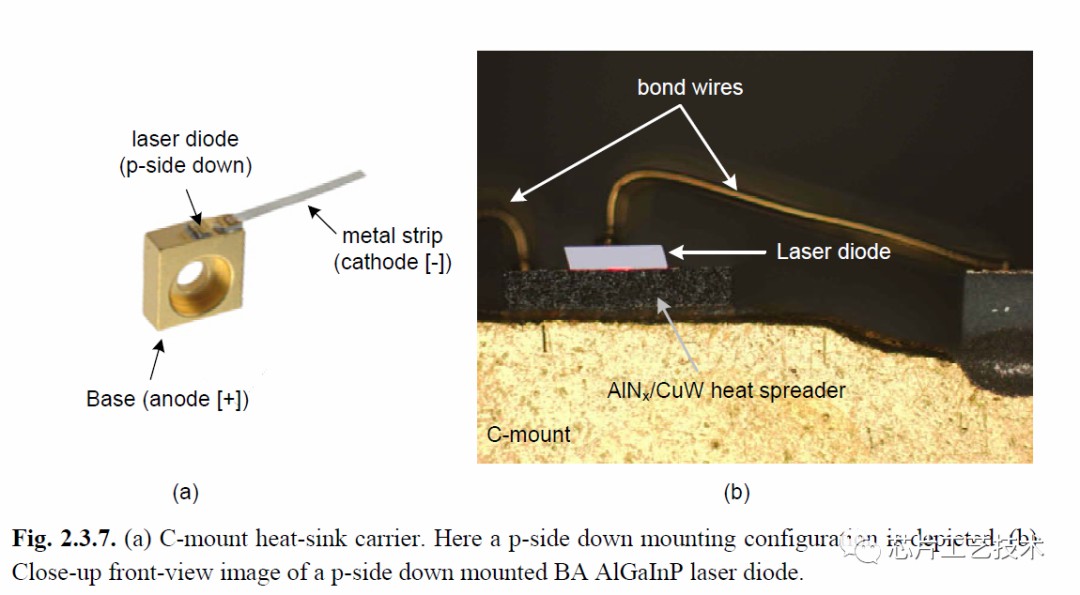
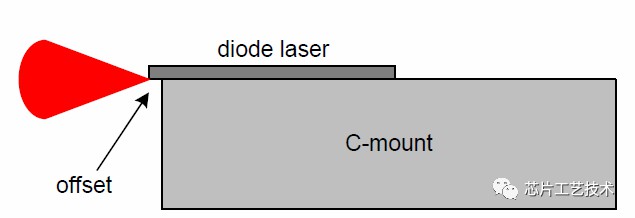

2.2 TO封装
TO封装技术,其实指Transistor Outline或者Through-hole封装技术,也就是全封闭技术,成本低,工艺简单。



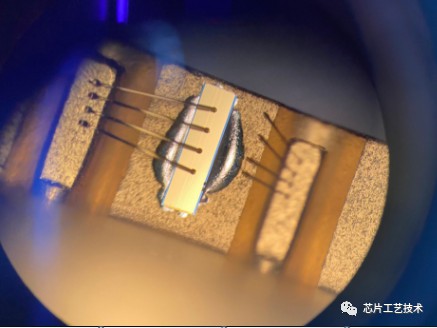
把芯片焊接在TO基座上,然后盖上帽子,且要在真空的环境下盖帽。

同样是TO封装,帽子也有不同。
2.3 、欧司朗光电半导体投影仪专用多晶粒激光器封装

独一无二的 50 W 光学输出功率:欧司朗光电半导体最新的激光器模块 PLPM4 450 大幅简化了专业激光投影仪的构造。这是第一次将多达 20 颗蓝光激光器芯片封装进一个小型外壳里。而且,每颗芯片的光功率都翻了一倍,因而总功率达到了 50 W,使得投影仪仅用一个外壳即可获得超过 2000 流明的亮度。
优势
多晶粒封装利于集成进投影仪,原因有三:
组装
需要组装的元件少了,组装时间就缩短了。多达 20 颗激光器芯片被集中到单个封装中。
光学校准
大幅降低了光学校准的复杂性:光束准直时只需单片多透镜阵列。
形状因素
多晶粒封装是高度集成的封装,因而尺寸特别小。
特点
–蝶形封装;当外壳温度(Tcase)为 65°C 时,输出光功率达 50 W
–多达 5 颗多模激光器芯片呈串联连接,粘合在 4 支激光棒上
–每支激光棒均可单独运行
–波长:450 nm +/-10nm
–当外壳温度(Tcase)为 25℃时,典型电光转换效率为 35%
–每颗激光器芯片都有静电保护二极管
–工作温度:10°C ~ 70°C


